MOSHEMT: Neuartige Transistortechnik erreicht Grenzfrequenzen von 640 GHz
Forschern am Fraunhofer IAF haben eine neue Art von Transistoren mit extrem hohen Grenzfrequenzen entwickelt, die die Vorteile von III-V-Halbleitern mit denen von Silizium-MOSFETs kombinieren: Metalloxidhalbleiter-HEMTs (MOSHEMT).
Anbieter zum Thema
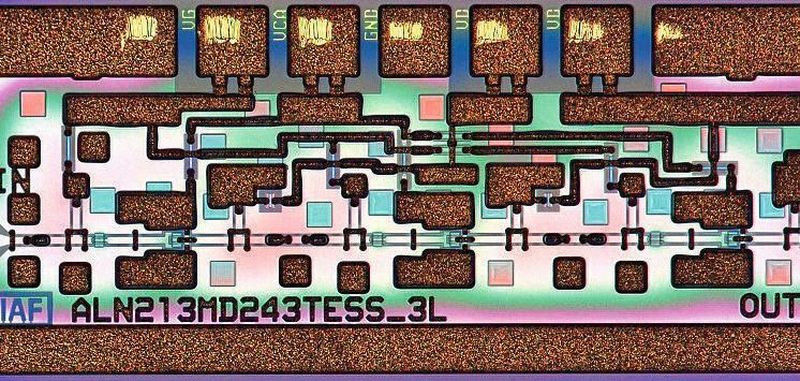
Transistoren mit hoher Elektronenbeweglichkeit, sogenannte HEMT (high-electron-mobility transistor), sind eine spezielle Bauform des Feldeffekttransistors, die insbesondere für HF-Anwendungen gut geeignet ist. Der Transistor besteht aus verschiedenen Halbleiterwerkstoffen mit unterschiedlichen Bandlücken. Der klassische HEMT aus III-V-Halbleitern wie Indium-Aluminiumarsenid ist bei einer Gate-Länge von 20 nm an einem Limit angelangt, bei dem eine weitere Miniaturisierung aufgrund von Leckströmen nicht mehr möglich ist.
Auch bei Silizium-MOSFETs tritt dieses Problem auf. Allerdings haben diese eine Oxidschicht, die ungewollte Leckströme länger unterbindet als dies beim HEMT der Fall ist.
Vorteile der Transistor-Technologien HEMT und MOSFET kombiniert
Die Forscher am Fraunhofer-Institut für Angewandte Festkörperphysik haben die Vorteile von III-V-Halbleitern und Silizium-MOSFETs kombiniert und die Schottky-Barriere des HEMTs durch eine isolierende Oxidschicht ersetzt. Entstanden ist eine neue Art von Transistor: der Metalloxidhalbleiter-HEMT, kurz MOSHEMT.
„Wir haben ein neues Bauelement entwickelt, dass das Potenzial besitzt, weit über das hinaus zu gehen, was bisherige HEMTs leisten können. Der MOSHEMT ermöglicht es uns, ihn noch weiter zu skalieren und damit noch schneller und leistungsfähiger zu machen“, erklärt Dr. Arnulf Leuther, Forscher im Bereich der Hochfrequenzelektronik am Fraunhofer IAF.
Mit der neuen Transistor-Technologie ist es Leuther und seinem Team gelungen, einen Rekord in der maximalen Oszillationsfrequenz von 640 GHz zu erreichen. „Das übertrifft den weltweiten Stand der Technik für jegliche MOSFET-Technologie, einschließlich Silizium-MOSFETs“, fügt er hinzu.
Hohe Barriere gegen Leckströme
Um die zunehmenden Gate-Leckströme zu unterbinden, mussten die Forscher ein Material mit deutlich höheren Barrieren als die klassische Schottky-Barriere einsetzen. Daher haben sie die Halbleiter-Barriere durch eine Kombination isolierender Schichten ersetzt, die aus Aluminiumoxid (Al2O3) und Hafniumdioxid (HfO2) bestehen.
„Dadurch konnten wir den Gate-Leckstrom um mehr als den Faktor 1000 reduzieren. Die ersten hergestellten MOSHEMTs demonstrieren ein sehr hohes Entwicklungspotential, während die bestehenden Feldeffekttransistor-Technologien bereits ihr Limit erreicht haben“, berichtet Dr. Axel Tessmann, ebenfalls Forscher am Fraunhofer IAF.
Weltweit erste integrierte Schaltung mit MOSHEMTs
Der ultra-schnelle MOSHEMT ist für Frequenzen oberhalb von 100 GHz ausgelegt und damit für neuartige Kommunikations-, Radar- sowie Sensoranwendungen besonders interessant. Derartige Bauelemente könnten in Zukunft für eine schnellere Datenübertragung zwischen Funkmasten sorgen und abbildende Radarsysteme für das autonome Fahren sowie eine höhere Auflösung und Genauigkeit von Sensoren ermöglichen.
Es wird noch einige Jahre dauern, bis der MOSHEMT den Weg in diese Anwendungen findet. Die Forscher am Fraunhofer IAF haben allerdings bereits den weltweit ersten Verstärker-MMIC (Monolithic Microwave Integrated Circuit) auf Basis von InGaAs-MOSHEMTs für Frequenzen zwischen 200 und 300 GHz realisiert.
:quality(80)/images.vogel.de/vogelonline/bdb/1657200/1657202/original.jpg)
2D-MOSFET: Steht die Miniaturisierung von Transistoren vor dem Durchbruch?
(ID:46306401)





:quality(80)/p7i.vogel.de/wcms/9f/13/9f13686bb894142875a93de7f6c3aabe/0131278942v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/e1/9c/e19ca48e7ee7b6604240bdb1a02a3a7d/0131251245v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/8c/f0/8cf0a380137d81e18ab1683a061b7531/0131171547v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/4b/c1/4bc195078a1cc19f3f42f3fdea3cc8c5/0131260433v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/42/65/426590889d9cc3c850ba2ed6184b28d8/0131183751v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/61/a8/61a87a52d28be928c7874cd43193f3d4/0131178325v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/17/71/1771c0b139e32eced60c0f60abd045dc/0131202175v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/ab/6e/ab6ee4358adb3ef565a3af4e923dae6b/0131202314v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/a0/b7/a0b74e201c3d9a12af0a204e1e578aad/0131136338v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/d2/1c/d21cea8a73c1dc8b94322e896fb7cc2b/0131036508v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/be/81/be8197dbe5f61c3c5ade3732457725af/0131041847v1.jpeg)
:quality(80)/p7i.vogel.de/wcms/58/ed/58ede6960020a2ded5f6771bd9b8e49d/0131277913v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/77/06/77065703c81be2dd11397359059b74ca/0131276872v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/fa/22/fa22ead6e6fe569ec03e08eba146bedc/0131141465v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/2e/78/2e789ef76c84f5fcdf02b5697a22f9ab/0131062677v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/d4/1d/d41d81ec84a42b4fd5d732d36d0021ce/0130877962v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/9c/79/9c798ab2b4c18ba0a2c24f2491798d36/0130550888v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/b6/e7/b6e755d9e704319c0bb59dc1ac2d67e8/0130537290v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/34/1f/341f0c9b899c7509a01c9a13383af6cf/0131148001v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/ca/8c/ca8cda9df29d8b2cf6f7b09abd8b7dda/0131065542v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/fa/71/fa71d141fca285824eb23f3aba1333f2/0131012876v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/05/83/0583267ea76f0beb94c4acef52d485e1/0130855074v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/b5/54/b5548923d20a751319550a3eb159af21/0131159519v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/87/b6/87b60368567da3c6b65107c55f5f69ec/0130689118v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/b4/55/b455edd54c7e92e0f5bf2d059e2cc5ca/0130990400v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/22/c5/22c556143a9c1d17bff3c3ab153a1120/0131275477v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/fa/42/fa424fa7fe94e1ba17869e270e2b2422/0131203375v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/75/10/75102cf1bcc950d376da7fc4e9722ebe/0131066528v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/d6/ea/d6eac438c362c545cab42ef0f30bcfc0/0130136975v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/e5/6c/e56ceb935ba09cb66a4fd0f961b2d3e9/0129642888v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/69/1f/691f39ba12be3cad90eb88bdabc456a6/0127321404v2.jpeg)
:fill(fff,0)/p7i.vogel.de/companies/63/88/63887b860cf66/me-logo-400px.jpeg)
:fill(fff,0)/images.vogel.de/vogelonline/companyimg/93300/93330/65.jpg)
:fill(fff,0)/images.vogel.de/vogelonline/companyimg/9600/9682/65.jpg)
![Vergleich von Van-der-Waals- und Zipper-2D-Materialien: Struktur eines typischen vdW-Materials wie Bi₂O₂Se (alternativ: Molybdändisulfid oder Graphen) mit einem vdW-Spalt [Visualisierung (a)] und Struktur eines Zipper-Materials wie Bi₂SeO₂, das sich durch das Fehlen eines solchen Spalts in der Kristallstruktur und durch halb besetzte Oberflächen auszeichnet, postulieren Forscher der Peking-Universität [Visualisierung (b)]. (Bild: ACS Nano 2025, 19, 10, 9788-9800) Vergleich von Van-der-Waals- und Zipper-2D-Materialien: Struktur eines typischen vdW-Materials wie Bi₂O₂Se (alternativ: Molybdändisulfid oder Graphen) mit einem vdW-Spalt [Visualisierung (a)] und Struktur eines Zipper-Materials wie Bi₂SeO₂, das sich durch das Fehlen eines solchen Spalts in der Kristallstruktur und durch halb besetzte Oberflächen auszeichnet, postulieren Forscher der Peking-Universität [Visualisierung (b)]. (Bild: ACS Nano 2025, 19, 10, 9788-9800)](https://cdn1.vogel.de/00u4Ru7t3zOGgwVOUfjVTxfJfsc=/392x392/smart/filters:format(jpg):quality(80)/p7i.vogel.de/wcms/18/85/18856f727fff1ee9a0b57955a0f0b2b4/0125135007v1.jpeg)
:quality(80)/p7i.vogel.de/wcms/79/4f/794f5df37149f91f8cca2c82e7cf7d4a/0127804057v3.jpeg)