Anbieter zum Thema

Für den Schnitt von Komplettkonturen empfiehlt LPKF eine maximale Stärke bis 1,6 mm, je nach eingesetzter Laserquelle. Durch einen längeren Schneidprozess sind auch deutlich größere Materialstärken möglich.
Einsatzgebiete von UV-Laserschneidsystemen
UV-Laserschneidsysteme zeigen ihre besonderen Stärken bei kleinen, dünnen und flexiblen Leitungsträgern. Je nach Stärke des Leiterplattenmaterials sind ein oder mehrere Schnitte entlang der gewünschten Kontur erforderlich. Je dünner das Material, desto schneller der Schneidprozess. Dabei erfasst ein Vision-System gegebenenfalls Verformungen aus Vorprozessen und gleicht Verschiebungen oder Rotationen im Prozess aus.
Im gleichen Arbeitsschritt kann der Laser eine Gravierung des Substrats vornehmen. So lassen sich eindeutige Bauteilmarkierungen für Tracking & Tracing beim Separationsprozess aufbringen.
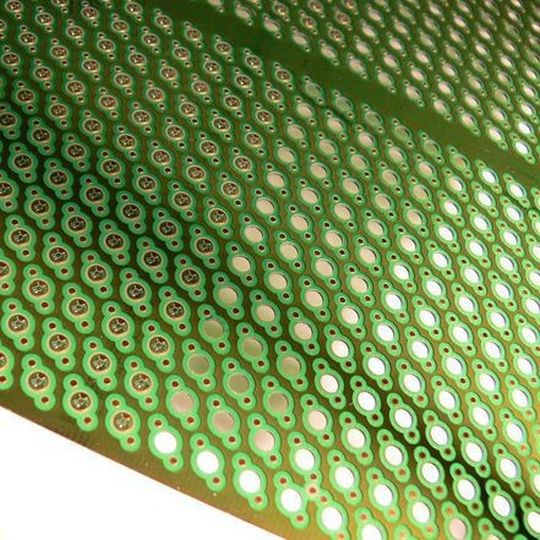
Das gilt auch für Decap-Anwendungen und Taschen in Multilayern: Dabei trennt der UV-Laser starre und flexible Komponenten voneinander oder öffnet nichtlaminierte Bereiche in mehrlagigen Leiterplatten.
* Malte Borges ist PR-Referent für Produktkommunikation beim Garbsener Lasertechnikspezialisten LPKF (www.lpkf.de).
(ID:43057256)





:quality(80)/p7i.vogel.de/wcms/9f/13/9f13686bb894142875a93de7f6c3aabe/0131278942v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/e1/9c/e19ca48e7ee7b6604240bdb1a02a3a7d/0131251245v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/8c/f0/8cf0a380137d81e18ab1683a061b7531/0131171547v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/4b/c1/4bc195078a1cc19f3f42f3fdea3cc8c5/0131260433v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/42/65/426590889d9cc3c850ba2ed6184b28d8/0131183751v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/61/a8/61a87a52d28be928c7874cd43193f3d4/0131178325v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/17/71/1771c0b139e32eced60c0f60abd045dc/0131202175v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/ab/6e/ab6ee4358adb3ef565a3af4e923dae6b/0131202314v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/a0/b7/a0b74e201c3d9a12af0a204e1e578aad/0131136338v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/d2/1c/d21cea8a73c1dc8b94322e896fb7cc2b/0131036508v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/be/81/be8197dbe5f61c3c5ade3732457725af/0131041847v1.jpeg)
:quality(80)/p7i.vogel.de/wcms/58/ed/58ede6960020a2ded5f6771bd9b8e49d/0131277913v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/77/06/77065703c81be2dd11397359059b74ca/0131276872v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/fa/22/fa22ead6e6fe569ec03e08eba146bedc/0131141465v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/2e/78/2e789ef76c84f5fcdf02b5697a22f9ab/0131062677v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/d4/1d/d41d81ec84a42b4fd5d732d36d0021ce/0130877962v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/9c/79/9c798ab2b4c18ba0a2c24f2491798d36/0130550888v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/b6/e7/b6e755d9e704319c0bb59dc1ac2d67e8/0130537290v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/34/1f/341f0c9b899c7509a01c9a13383af6cf/0131148001v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/ca/8c/ca8cda9df29d8b2cf6f7b09abd8b7dda/0131065542v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/fa/71/fa71d141fca285824eb23f3aba1333f2/0131012876v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/05/83/0583267ea76f0beb94c4acef52d485e1/0130855074v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/b5/54/b5548923d20a751319550a3eb159af21/0131159519v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/87/b6/87b60368567da3c6b65107c55f5f69ec/0130689118v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/b4/55/b455edd54c7e92e0f5bf2d059e2cc5ca/0130990400v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/22/c5/22c556143a9c1d17bff3c3ab153a1120/0131275477v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/fa/42/fa424fa7fe94e1ba17869e270e2b2422/0131203375v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/75/10/75102cf1bcc950d376da7fc4e9722ebe/0131066528v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/d6/ea/d6eac438c362c545cab42ef0f30bcfc0/0130136975v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/e5/6c/e56ceb935ba09cb66a4fd0f961b2d3e9/0129642888v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/69/1f/691f39ba12be3cad90eb88bdabc456a6/0127321404v2.jpeg)
:fill(fff,0)/p7i.vogel.de/companies/69/9c/699c6104d5166/logo-pp-rot-quadratzuschnitt-inv512px.png)
:fill(fff,0)/p7i.vogel.de/companies/60/f6/60f6829670d63/beta-layout-logo.jpeg)
:fill(fff,0)/p7i.vogel.de/companies/5f/88/5f8847c90d2e4/50-mm.jpg)
:quality(80)/p7i.vogel.de/wcms/d2/f1/d2f1723bcc4f93a4d92244295f074472/0125932779v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/02/a6/02a682df26d6719ff336c961bd08213f/0125019920v2.jpeg)