Elektronische Flachbaugruppen kühlen Koppeleffekte bei der Aufbautechnik berücksichtigen
Bei der Aufbautechnik sollten zwischen Bauelementen auf einer Platine Koppeleffekte bei der thermischen Optimierung berücksichtigt werden. Eine geringere thermische Leitfähigkeit des eingesetzten Wärmeleitelastomers oder gar keine thermische Verbindung kann unter Umständen sogar vorteilhafter für das Gesamt-Wärmemanagement sein.
Anbieter zum Thema
Bei Flachbaugruppen wie bestückten SMD-Leiterplatten steht das Gehäuse als ein idealer Kühlkörper zur Verfügung. Rückenseitig leiten Prozessorbauelemente, MOSFET-Leistungshalbleiter, Speicherbauelemente etc. über elastomere Interface-Materialien einen Teil ihrer Verlustleistungen an das Gehäuse ab. Die Restverluste der Halbleiter werden über die gelöteten Pins oder die Bauelementunterseiten sowie konvektiv und durch Strahlung abgegeben. Da das Gehäuse die Verlustwärme aller angebundenen Bauelemente aufnimmt, sind diese thermisch miteinander gekoppelt. Diese Kopplung führt unmittelbar zu Wechselwirkungen.
Einen typischen Aufbau eines Prozessorboards zeigt Bild 1. Im stationären Zustand findet ein Ausgleich der Erwärmungen zwischen den Bauelementen statt, was bei hohen Temperaturgradienten und hoher Umgebungstemperatur im ungünstigen Fall zur Erwärmung von Bauelementen führen kann. Dieses Phänomen muss bei der Positionierung der Bauelemente, der Wahl der Wärmeleitelastomere und der Formgebung der Wärmesenke berücksichtigt werden. Das Verhalten von wärmeleitenden Elastomeren, sogenannten Gap Fillern, ist maßgeblich durch die thermische Leitfähigkeit (typischerweise von 0,5 bis 10 W/mK und mehr), die Dicke (üblich sind 0,5 bis 10 mm) und die elasto-plastische Verformungseigenschaft definiert. Die folgende Analyse basiert auf den Ergebnissen von CFD-Strömungssimulationen.
CFD-Strömungssimulation für drei charakteristische Situationen
Die Untersuchungen stellen charakteristische und vereinfachte stationäre Situationen nach dem transienten Ausgleich von drei unter Last stehenden Bauelementen dar: Prozessor 0 (Oberfläche 7,8 mm²), Prozessor 1 (Oberfläche 12,3 mm²), SIMM-Speicher.
Die Bauelemente sind szenarioabhängig durch Wärmeleitelastomere mit dem Gehäuse thermisch verbunden oder im anderen Fall thermisch nicht an das Gehäuse gekoppelt. Der Aufbau geht davon aus, dass die Bauelemente einzeln auf einer FR-4-Leiterplatte bestückt sind. Als Wärmeleitelastomere stehen zwei Typen mit Leitfähigkeiten von 0,5 und 2 W/mK zur Verfügung. Ihre Dicke beträgt 2 mm. Die Verlustleistungen der Prozessoren betragen 16 und 2 W.
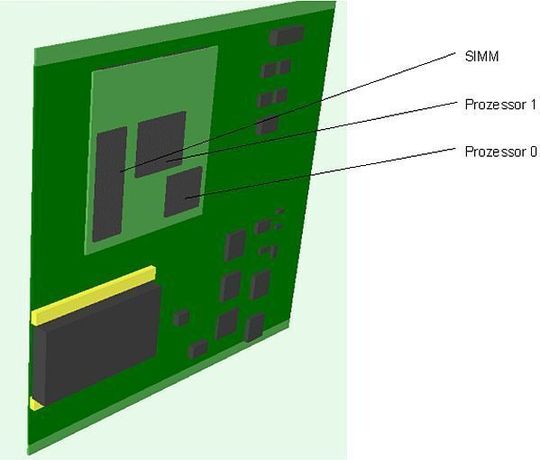
Die von anderen Bauelementen auf die Leiterplatte übertragene zusätzliche Verlustleistung ist geringfügig und lässt sich als untergeordnetes Grundrauschen ohne Einfluss vernachlässigen. Die Umgebungstemperatur wird als konstant angenommen. Das Gehäuse besteht aus Aluminium. Das Bild zeigt den Grundaufbau eines bestückten Prozessorboards.

In der Tabelle sind die Rahmendingungen und Prozessparameter der Szenarien gegenübergestellt. Eine Darstellung der Temperaturen im Vergleich finden Sie in der Bildergalerie.
Unterschiedliche thermische Rückkoppeleffekte
Es wird deutlich, dass im Szenario 0 im thermisch eingeschwungenen Zustand am Prozessor 1 mit Pv = 16 W die niedrigste Temperatur erreicht wird. Wird am Prozessor 0 der Gap Filler weggelassen (Szenario 2), sinkt die Temperatur an diesem Bauteil um 5 K. Am Prozessor 1 hingegen steigt die Temperatur um 1,5 K. In diesem Fall (Szenario 2) liegt die mittlere Leiterplattentemperatur am niedrigsten.
Szenario 1 zeigt, dass sich bei Einsatz von schlechteren Wärmeleitmaterialien mit 0,5 W/mK die Temperatur am Prozessor 1 um 4 K erhöht, aber am Prozessor 0 um 1,2 K sinkt.
In Szenario 3 wurde das Wärmeleitelastomer am Prozessor 0 wieder entfernt. Am Prozessor 0 sinkt die Temperatur um fast 4 K und am Prozessor 1 steigt sie um ca. 1 K gegenüber Szenario 1.
In den Szenarien 0 und 1 ist die Richtung des Wärmeflusses vom Kühlkörper zum Prozessor 0 hin. Es kommt zu einer thermischen Rückkopplung. Das Vermeiden der Rückkopplung durch Entfernen des Wärmeleitelastomers bei Prozessor 0 in den Szenarien 2 und 3 führt zu einer Temperaturerhöhung des heißeren Prozessors 1 um bis zu 5 K.
Durch den Einsatz zweier unterschiedlicher Interface-Materialien (Szenario 4) mit 2 W/mK am Prozessor 1 und 0,5 W/mK am Prozessor 0 wird nur eine sehr kleine Temperaturerhöhung am Prozessor 1 ermittelt. Hingegen stellt sich am Prozessor 0 eine um fast 1 K geringere Temperatur gegenüber Szenario 0 ein.
Die thermische Anbindung durch Wärmeleitelastomere und deren Auswahl beeinflussen also diese Koppeleffekte.
*Dr. Wilhelm Pohl ist Geschäftsführer der HALA Contec GmbH & Co. KG, Jürgen Schmidt arbeitet als Senior Consultant Thermal Management bei ServiceForce.Com GmbH.
(ID:220732)





:quality(80)/p7i.vogel.de/wcms/46/7c/467c0afffbfd10c3553c2888a4a6289f/0130479810v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/12/3d/123d9eb2c2e4ce13296371a2ad3718a4/0130412664v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/d8/78/d878b7bfc23826e6ddfce42443836d28/0130384280v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/13/20/13208d1c2797edd67d9ff216b403726b/0130471595v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/38/cb/38cbe19e814dd30b94780bc3946547ab/0130446533v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/a3/3e/a33e6d8a927d539ec6c3a0537f48f0f1/0130440028v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/6b/61/6b61373f1c3f06f7f9343e6b0f0e9cc8/0130225062v1.jpeg)
:quality(80)/p7i.vogel.de/wcms/15/93/1593dd152e6d58c5fc5da0d331777c54/0130357398v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/c2/88/c28805ea7b2261235475146a5b0c61f8/0130313028v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/fa/8d/fa8dedee195f29c33c89d86311c258ee/0130104146v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/cc/13/cc1378375499a26b5ddbb309d2155acb/0130085649v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/6d/91/6d91abfa1b16ffcf470c7147facd7aa8/0130387695v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/85/b0/85b0b32128f6d1968e975043f1e0b67b/0130342166v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/1a/53/1a539631c940d184689460600bd2b395/0130410666v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/10/45/1045969e69a1db4aaa73d0f74f55cc02/0129962687v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/cd/32/cd3243e4a9a6476265ef6ea9463dfbd8/0129852659v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/c7/f6/c7f61d0437c7f8fca3c6ff947ba2ad62/0129322490v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/ba/e4/bae4e54395e5a53088060531ef99b814/0130359274v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/35/af/35af7dd326d198475d06fbb69aa600b5/0130175971v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/c0/2e/c02e7bf72bfc434888c37100e2511681/0130127767v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/7c/04/7c04916c305164fb10bc6cb05b51d934/0130431065v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/64/e5/64e5e333492f182ab7df5ab4c2b54c1e/0130463252v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/0a/95/0a95db4508128c4e11d5d268bf2c0a77/0130440053v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/b3/65/b365dd5433c8b6d36c56c92b72f5b368/0130401081v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/85/c0/85c0cdd8fd326013aed52ca96777c998/0130426877v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/f0/78/f07826d6c4e995980f1ada3377416aac/0130403626v4.jpeg)
:quality(80)/p7i.vogel.de/wcms/b6/c8/b6c8f7732da417bda3d298412f4c0ed8/0130453104v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/47/ce/47ce64bad7990f276f68cbb24505f6dd/0130472850v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/15/56/15564dea31861c376a385658c3b961a3/0130465243v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/98/ad/98ad595a6372aae8dbeac71681d23f41/0130450258v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/bf/2a/bf2aad428ab1a80e6738fdbdc2efeb7e/0130453420v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/d6/ea/d6eac438c362c545cab42ef0f30bcfc0/0130136975v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/e5/6c/e56ceb935ba09cb66a4fd0f961b2d3e9/0129642888v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/69/1f/691f39ba12be3cad90eb88bdabc456a6/0127321404v2.jpeg)
:fill(fff,0)/p7i.vogel.de/companies/66/1f/661fa8e004810/heitec-logo-2024-1200px-ae.png)
:fill(fff,0)/p7i.vogel.de/companies/62/16/621651a93b1ef/logo-we-rgb-pos.png)
:fill(fff,0)/images.vogel.de/vogelonline/companyimg/56200/56252/65.jpg)
:quality(80)/p7i.vogel.de/wcms/66/c1/66c14543fd48c69fe35aeca2e513966a/0125007023v5.jpeg)
:quality(80)/p7i.vogel.de/wcms/67/08/6708123c5c01f8b51299aee83b938579/0127450020v3.jpeg)