Power-Module Verbesserungen in der Verbindungs- und Aufbautechnik liefern neunfach längere Lebendauer
Mit einfachen Mitteln, bewährter Verbindungstechnik und der entsprechenden Fachkenntnis lässt sich die Lebensdauer von Leistungshalbleiter-Modulen um das 9-fache steigern. Wie es geht, verrät dieser Beitrag.
Anbieter zum Thema
Steigende Anforderungen an die Zuverlässigkeit moderner Leistungselektronik verlangen immer wieder nach neuen Konzepten in der Verbindungs- und Aufbautechnik dieser Module. Neue Verfahren zur Anbindung der Leistungsbauteile auf das Substrat werden entwickelt und haben entscheidenden Einfluss auf die Lebensdauer. Eine zentrale Rolle bei diesen Betrachtungen spielt nach wie vor auch die Kontaktierung der Chipoberseite mittels Drahtverbindungen. Die hierbei eingesetzte Methode des Ultraschallverschweißens ist rein physikalisch gesehen leicht zu verstehen.
Sie bietet jedoch immer noch weitere Optimierungsmöglichkeiten zur Steigerung der Zuverlässigkeit, da das Versagen dieser Verbindung einer der Hauptausfallgründe eines Leistungsbauteiles ist. Natürlich spielt hierbei auch die Verbindungstechnik zwischen Leistungshalbleiter-Chip und Substrat eine wichtige Rolle, dieser Aspekt wird hier aber nicht näher betrachtet.
Ergebnisse eines Zuverlässigkeitstests
Vielmehr soll neben der Anbindung des Bonddrahtes an die Chipoberseite auch der Einfluss der Bondloop-Geometrie auf die Zuverlässigkeit abgetestet werden. Dieser Aspekt wurde schon in einer Veröffentlichung von Ramminger unter rein mechanischer Belastung untersucht (Quelle: S. Ramminger, N. Seliger, G. Wachutka, Reliability Model for Al Wire Bonds subjected to Heel Crack failures, Proceedings of ESREF2000).
Was hier jedoch noch nicht betrachtet wurde sind die Eigenschaften dieser optimierten Geometrie in einem Power-Cycling-Test. Hier wird neben der mechanischen auch die thermische Belastung unter Bedingungen getestet, die den realen Betriebsumgebungen von Leistungsmodulen am nächsten kommen. Die Ergebnisse dieser Zuverlässigkeitstests werden hier beschrieben.
Was das Versagen einer Verbindung verursacht
Ein Leistungsmodul erreicht das Ende seiner Lebensdauer meist aufgrund des Versagens der Bondverbindung auf der Chipoberseite. Hierbei kann man im Allgemeinen zwischen zwei Ausfallmechanismen unterscheiden. Der Bondabheber, verursacht durch das Versagen der Verbindung zwischen dem Bondfuß und der Chipmetallisierung aufgrund von Rissbildung auf der einen, und der Fersenbruch, ein Abbrechen des Bonddrahtes am Übergangsbereich zwischen Bondfuß und Bondloop, ebenfalls aufgrund von Rissbildung, auf der anderen Seite.
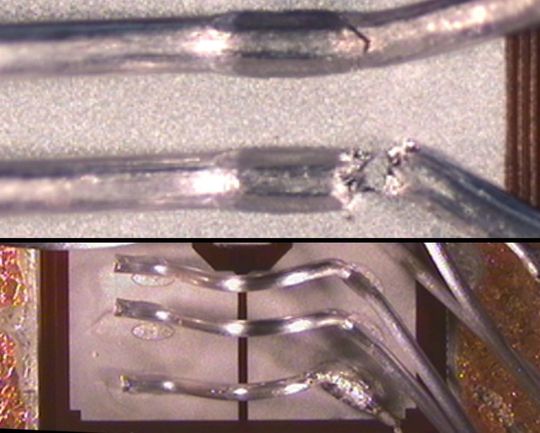
Dabei können sich beide Ausfallbilder gegenseitig beeinflussen. Der Fersenbruch eines oder mehrerer Drähte führt dazu, dass nun mehr Strom über die übrigen Bonddrähte und damit Bondfüße geleitet wird. Dies führt zu einer übermäßigen Erwärmung dieser Verbindungen und letztendlich zum verfrühten Ausfall aufgrund von Bondabhebern. Bei der Analyse von ausgefallenen Leistungsbauteilen kann aber in den meisten Fällen unterschieden werden, welcher der beiden Mechanismen als erstes auftrat und damit als Hauptausfallursache angesehen werden kann.
Die Hauptausfallursache des Bondabhebers kann durch eine Optimierung der Bondparameter Kraft, Leistung und Zeit auf die entsprechende Oberfläche oder deren entsprechende Vorbehandlung möglichst weit hinausgezögert werden. Sicherlich haben diese Parameter auch einen Einfluss auf das Auftreten von Fersenbrüchen. Eine zu hohe Bondkraft und Bondleistung kann den Übergangsbereich zwischen Bondfuß und Bonddraht entsprechend vorschädigen und dann unter Belastung zu einem frühzeitigen Ausfall führen. Einen weiteren großen Einfluss auf das Auftreten von Fersenbrüchen hat die allgemeine Geometrie des Bonddrahtes, also die Loopformung zwischen zwei Bondfüßen.
Gezielte Optimierungen der Bondloops
Die in diesem Artikel beschriebenen Untersuchungen wurden mit Drahtdicken größer 100 µm, also Dickdraht, durchgeführt. Bild 3 zeigt schematisch den Verlauf eines solchen Bonddrahtes.

Dabei sind vor allem die drei eingezeichneten Parameter Loophöhe, Bondfußabstand und Position-Bondloop interessant. In der erwähnten Veröffentlichung von Ramminger konnte gezeigt werden, dass vor allem das Verhältnis von Loophöhe zu Loopweite unter rein mechanischer Belastung den größten Einfluss auf die Zuverlässigkeit hat. Da der Bondfußabstand bei den von uns verwendeten Testmodulen nicht variiert werden konnte, wurde lediglich die Loophöhe verändert und deren Auswirkung auf die Zuverlässigkeit in Power-Cycling-Tests untersucht. Der Faktor „Position-Bondloop“ wurde nicht explizit betrachtet bzw. gezielt variiert. Er ergibt sich aus den gewählten Loop-Parametern und der Loophöhe.
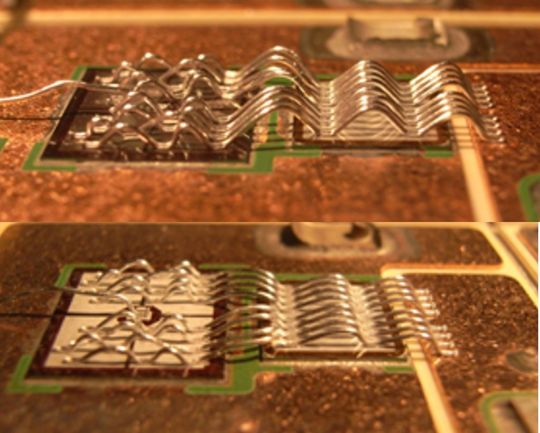
Es wurden nun Bauteile mit verschiedenen Loophöhen für die nachfolgenden Tests aufgebaut. Um sicher zu stellen, dass alle erhaltenen Ergebnisse rein auf die unterschiedlichen Loophöhen und nicht etwa auf eventuell auftretende Ermüdungen der Verbindungsschicht zwischen Chip und Substrat zurückzuführen sind, wurden alle Testbauteile mittels Sintertechnologie aufgebaut.
Die Rolle der Loop-Geometrie im Zuverlässigkeitstest
Als Kriterium zur Bewertung der Zuverlässigkeit der verschiedenen Loophöhen, galt die erreichte Zyklenzahl bis zum Ausfall und das hier auftretende Ausfallbild in einem Power-Cycling-Test. Es wurde eine Testbedingung von ΔT = 70 K (80 bis 150 °C) gewählt. Erfahrungen haben gezeigt, dass bei diesem Temperaturhub besonders die Bondverbindung auf der Chipoberseite belastet wird und somit die Ergebnisse direkte Rückschlüsse auf den Einfluss der Loop-Geometrie zulassen.
Während der Dauer der Power-Cycling-Tests wurden die Umschalttemperaturen protokolliert. Es ergab sich bis zum letztendlichen Versagen der Bondverbindung und damit dem Ausfall des Leistungsmoduls keine zusätzliche Erwärmung der Versuchsanordnung.
Die Ergebnisse der Untersuchung
Nach Durchführung der Power-Cycling-Tests hat sich gezeigt, dass der Einsatz hoher Bondloops zu einer deutlichen Steigerung der Zyklenzahl führt. Eine Erhöhung der Loops von etwa 1,3 mm auf 3 mm führte zu einer Steigerung der zu erwartenden Lebensdauer von rund 70.000 auf 650.000 Lastwechsel-Zyklen. Dabei ergibt sich diese Steigerung hauptsächlich aus der Tatsache, dass sich das Fehlerbild von relativ früh auftretenden Fersenbrüchen hin zu wesentlich später auftretenden Bondabhebern verlagert. Die erhöhte Loop-Geometrie hat tatsächlich auch unter thermomechanischer Belastung eine stark positive Auswirkung auf die Zuverlässigkeit von Leistungsmodulen.
In den Testreihen konnte also deutlich gezeigt werden, dass eine Optimierung der Loop-Geometrie hinsichtlich der maximalen Bondhöhe die Zuverlässigkeit von Leistungshalbleiter-Bauteilen auch in Power-Cycling-Tests wesentlich verbessern und die Lebensdauer um das 9-fache steigern kann. Grund hierfür ist das Vermeiden von relativ früh auftretenden Fersenbrüchen. Dies zeigt, dass die von Ramminger gefundenen Erkenntnisse auch auf Testbedingungen angewendet werden können, die den realen Umgebungsbedingungen von Leistungsbauteilen sehr nahe kommen.
*Christoph Scheuermann ist Prozess-Ingenieur bei SEMIKRON, Nürnberg.
Artikelfiles und Artikellinks
(ID:357639)





:quality(80)/p7i.vogel.de/wcms/39/60/3960ad6bca80ca1cb5a8a2c9324ffb1d/0129805397v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/f1/2f/f12fcea90f39543f7eeb41528887fffd/0129805649v6.jpeg)
:quality(80)/p7i.vogel.de/wcms/2f/bc/2fbc41c5140905b15698225ff58b203e/0129648135v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/c2/a7/c2a785307c8778bb7e97c2bfd5f2e39b/0129826901v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/5c/42/5c4277b2a48f97332adfc485d6c7aee6/0129494885v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/26/c7/26c7a8a41420adecc0864c3001233ac3/0129722027v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/53/fc/53fcc66b478a0859ff3a7818d6bb4e05/0129773718v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/7b/57/7b5725dd2e7545ab4904a9b7a3735721/0129309389v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/e1/78/e17860d5b42a0bc53e323868d2777d79/0129752421v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/92/43/9243cfe82b7ab3448679ded83cb50204/0129762425v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/30/1f/301fa3142221a2ee6ba3ef07e89a4ec8/0129690250v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/e1/2d/e12d843be72a9dc1cab04b68f1c39e4a/0129691802v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/c7/f6/c7f61d0437c7f8fca3c6ff947ba2ad62/0129322490v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/66/0c/660c31afa35398bac9be42f2be73fdc4/0129073529v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/9c/35/9c35ed04fa562b190cbc496a695a6802/0128823288v1.jpeg)
:quality(80)/p7i.vogel.de/wcms/7b/70/7b700e93abd717e2feb5466810810af4/0127597143v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/bf/e7/bfe77bc5e9766b56129987dabf83134f/0129479309v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/8b/e8/8be874cadb88f7d40c58381cd26f0122/0129697493v3.jpeg)
:quality(80)/p7i.vogel.de/wcms/f3/21/f3219118c5e2062040c81b4c43687b16/0129793768v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/23/37/2337c3956a8f3d1cb3552ad197f0d78b/0129723446v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/17/9c/179c11641120399cf2e4cf0e5943b107/0129645476v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/4b/ae/4bae16790eefdf56e586f9f5261760f2/0129778970v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/6c/b2/6cb2f5a31e5d99bea02cfcac09fc6e53/0129765681v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/68/95/6895bd4fbdb1e9c84f6ebac2e11b03b3/0129764984v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/9d/13/9d131190bf01a4a85b6d63178e2567b8/0129778339v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/06/bf/06bf3e15e9d8ebc4f77a148b3066a8b8/0129680605v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/23/98/239867926f8ffeb4ab0c39c3a3abce3d/0129828950v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/e5/6c/e56ceb935ba09cb66a4fd0f961b2d3e9/0129642888v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/69/1f/691f39ba12be3cad90eb88bdabc456a6/0127321404v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/6a/cc/6acc4f803241cfe5b6d60560c0a2b4d9/0126684948v2.jpeg)
:fill(fff,0)/images.vogel.de/vogelonline/companyimg/93300/93330/65.jpg)
:fill(fff,0)/p7i.vogel.de/companies/69/7c/697cbb83628bc/logo-16-9.png)
:fill(fff,0)/images.vogel.de/vogelonline/companyimg/111200/111228/65.jpg)
:quality(80)/p7i.vogel.de/wcms/67/fc/67fc1449e69e0f99e382a008f31eec5a/0124431173v2.jpeg)
:quality(80)/p7i.vogel.de/wcms/df/41/df41bfae5223b6988b3291e519d36f47/0124990347v2.jpeg)